Medusa 82: Influence of post exposure bake (PEB)
The addition of photoacid generators (PAGs) can significantly increase the sensitivity of Medusa 82 (see Medusa with photoacid generator). Another option is to add a PEB after e-beam exposure. Even if substrates were previously stored for several days, the sensitivity significantly increases depending on the temperature and the duration of the PEB.

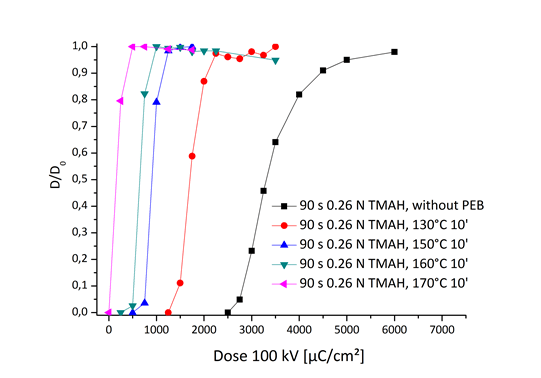
Gradation curve after PEB with different developers
As developers, 0.20 and 0.26 n TMAH solutions were used. The higher the chosen PEB temperature, the higher is also the sensitivity, and also the contrast increases due to the PEB.
Overview of photoresist FAQs
AR-N 7700-4um thick-proximity effect
Chemically amplified, highly sensitive negative e-beam resist SX AR-N 7730/37
Diffractive optics with the “analogous“ e-beam resist
High-resolution negative e-beam resist
High-resolution negative e-beam resist AR-N 7520.17new for etching application
Medusa 82 for EUV applications
Medusa 82 with photoacid generator (PAG)
Medusa 82 – the alternative to HSQ-resists, storage stability
Medusa 82: Influence of post exposure bake (PEB)
Ratio resolution and dose, exemplarily shown for e-beam resist SX AR-N 7530/1)
Sensitive, etch-stable negative e-beam resist for processes without yellow light