SX AR-N 4340/7 thermal stable negative photoresist
For one and two-layer system, thermal stable up to 300℃
…
SX AR-N 4340/7 product brief 產品說明
SX AR-N 4340/7 為耐高溫,化學增幅負型光阻,具高敏感度,sub-um解析度。耐溫可達300℃。
下切型結構(lift-off應用)可經由曝光顯影參數調整或與AR-BR 5400 bottom resist搭配為雙層製程。(2-layer system)。
產品基本資料如下:
| SX AR-N 4340/7 | ||
| Film thickness@4000rpm | um | 1.4 |
| Resolution | um | 0.7 |
| contrast | 5.0 | |
| Flash point | ℃ | 44 |
| Storage 6 months1 | ℃ | 10 – 18 |
| Production status2 | on-demand |
1. Storage 6 months
Shelf life is guaranteed for 6 months from the date of sales if stored at above mentioned condition.
2. Production status:
routine – 固定排程生產,交貨期約2 – 4週。
on-demand – 無固定排程生產,需先詢問。可能有最小訂購量或需待批次生產。
…
Packing & shipping 產品包裝與出貨
packing 產品包裝
✅ 250 ml/瓶
✅ 1 L/瓶
其它包裝可依需求研擬增加
shipping 產品出貨
✅ 2 – 4 週。德國運出。
❎ 1 週。 國內庫存。
(本產品暫無國內庫存)
本產品原廠為德國ALLRESIST GmbH. 瀏覽原廠網頁請按原廠標識。
This product is developed and produced by ALLRESIST GmbH.
Click logo to visit pricipal’s website.

…
Product features 產品特性
- i-line, g-line, deep UV (248 – 266 nm)
曝光波長: i-line (365nm) , g-line (436nm), deep UV (248 – 266 nm) - highest sensitivity, high resolution
高敏感度,高解析度 - good adhesion, high contrast, chemically enhanced
化學增幅型,具高對比,與基板黏著度良好 - undercut profiles (lift-off) are possible
可調整成下切型圖案,用於懸浮剝離製程 - may be used with AR-BR 5400 as 2-layer system
與AR-BR 5400搭配為雙層阻劑,用於懸浮剝離(lift-off)製程 - plasma etching resistant, thermostable up to 300℃
耐各類電漿蝕刻,耐溫可達攝氏300度 - polyhydroxystyrene polymer with photochemical acid generator and aminic cross-linker
成份含聚羥基苯乙烯高分子,光酸與架橋劑 - safer solvent PGMEA
使用較安全溶劑丙二醇甲醚醋酸酯
…
Product properties 產品物性


…
SX AR-N 4340/7 Spin curve 塗佈曲線

…
Structure and resolution 結構與解析度
Structure resolution

SX AR-N 4340/7
0.7 um resolution at film thickness of 1.4 um
Resist structure

Resist structure of SX AR-N 4340/7 after baking at 300℃
Process parameters
| Substrate | Si 4″ wafer |
| Soft bake | 90℃ x 60sec, hot plate |
| Exposure | i-line stepper (NA: 0.65) |
| Development | AR 300-47x60 sec, 22℃ |
Process chemicals
| Adhesion promoter | AR 300-80 new |
| Developer | AR 300-47 |
| Thinner | AR 300-12 |
| Remover | AR 600-71 |
…
Process baseline 製程參數
This diagram shows exemplary process steps for SX AR-N 4340/7 photoresists. All specifications are guideline values which must be adapted to own specific conditions. For further information on processing, 👉“ Detailed instructions for optimum processing of photoresists”. For recommendations on wastewater treatment and general safety instructions, 👉”General product information on Allresist photoresists”.
表列為SX AR-N 4340/7 系列產品製程參數的範例。所有參數為參考值,使用者應依設備環境實際狀況加以調整。
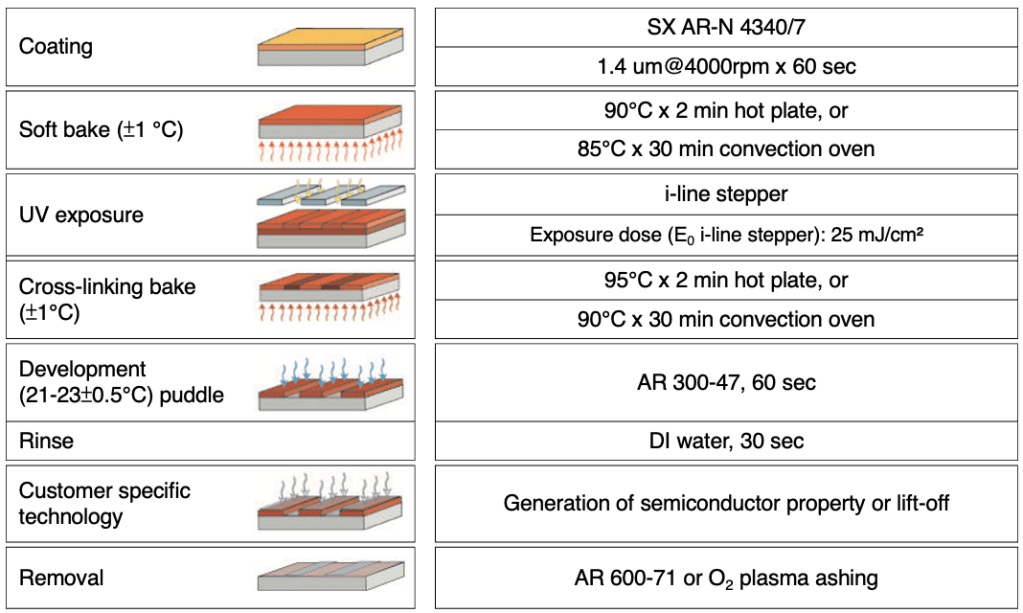
Processing instructions for the generation of lift-off structures and supplementary information
An undercut of the resist structure (lift-off) can be obtained with a prolonged development after minimum exposure. The undercut and structures with vertical side walls remain even at high temperatures of up to 300 °C. This high temperature stability is also used in the two-layer system with AR-BR 5400 and allows intensive sputtering processes at very high temperatures (see product information AR-BN 5400).
This resist formulation is currently successfully processed by customers, may however also be modified according to new customer’s requirements.
懸浮剝離製程,光阻下切結構的形成,需降低曝光劑量並增加顯影時間. 此種下切型結構可耐溫達300℃.與底層阻劑搭配使用,以雙層阻劑型成的深下切結構, 適合於高溫濺鍍製程.
本產品配方已於客戶製程成功應用. 如果有新製程應用可調整配方以達到需求.
…
Contents are base on ALLRESIST product TDS.
Click link to ALLRESIST SX AR-N 4340/7 page .
內容取材自原廠技術資料,連結原廠請按下方標識。

