AR 600-549 developer for e-beam resist
Ultra-pure, ultra filtered solvent mixture
…
AR 600-549 Product brief 產品簡介
專為AR-6200系列電子束微影阻劑調配的顯影劑有下列:
AR 600-546 高對比(14),對未曝光結構不會侵蝕,適合高解析度或高膜厚(e.g. 2um)應用。
AR 600-548 對比度約為3,敏感度比AR 600-546高約6倍 (at < 10uC/cm2)。降低顯影溫度可減少侵蝕現像(dark erosion)
AR 600-549 中等強度顯影劑,敏感度約為AR 600-546的2倍。對比可達4且對未曝光結構無侵蝕現像。
上述三種產品皆為較安全的混合溶劑。
…
Packing 產品包裝:
✅ 1 L/瓶
其它包裝可依客戶需求增加.
Shipping 出貨:
✅ 2 – 4 週: 徳國運出
❎ 1 週: 國內庫存
(目前暫無國內庫存)
…
Product Features 產品特性
- ultrapure, ultra-filtered (0.2 μm) solvent mixtures
超純度,超細過濾(0.2um)的混合溶劑 - storage at 10 – 22 °C for 6 months
儲存溫度 10 – 22 ℃ 可維持6個月的有效期限 - Main component(s): diethyl malonate/ anisole
主要成份:丙二酸二乙酯 / 甲氧苯
…
Product properties 產品物性

…
Dedicated developer for resist 適用阻劑
-
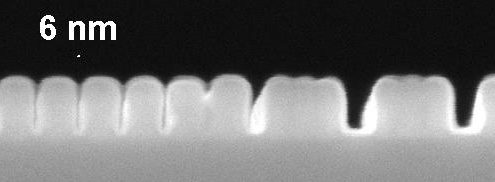
AR-P 6200 series
AR-P 6200 series (CSAR 62) Copolymer positive EBL resist Highest resol… read
…
AR 600 family introduction 電子束微影專用顯影劑說明
| 序號 | 包裝 | 適用EBL阻劑 | 主要成份 | 📤 GHS標識連結 |
|---|---|---|---|---|
| AR 600-50 | 1 L/瓶 | AR-P 617 MMA-MA copolymer resist | PGME/IPA | AR 600-50 GHS label |
| X AR 600-50/2 | 1 L/瓶 | new for AR-P 617(T-gate application) | Ethanol/IPA | X AR 600-50/2 GHS label |
| AR 600-55 | 1 L/瓶 | AR-P 600 PMMA resist | MIBK (stronger) | AR 600-55 GHS label |
| AR 600-56 | 2.5 L/瓶 | AR-P 600 PMMA resist | MIBK (weaker) | AR 600-56 GHS label |
| AR 600-57 | 1 L/瓶 | AR-P 600 PMMA resist | Ethanol (MIBK free) | AR 600-57 GHS label |
| AR 600-546 | 2.5 L/瓶 | AR 6200 copolymer resist | amyl acetate(weaker developer) | AR 600-546 GHS label |
| AR 600-548 | 1 L/瓶 | AR 6200 copolymer resist | diethyl ketone /diethyl malonate | AR 600-548 GHS label |
| AR 600-549 | 1 L/瓶 | AR 6200 copolymer resist | diethyl malonate/ anisole | AR 600-549 GHS label |
…
AR 600 family and resist development 系列產品及對應阻劑


…
Information on developer processing
The choice of the developer strongly influences the development rate, the sensitivity and the profile of the resist structures. Coated and exposed substrates are treated with developers which are suitable for the respective process (puddle, spray, immersion bath) at a temperature of 21-23 °C kept as constant as possible. The required development time depends in each case on the resist film thickness. Films with a thickness of less than 0.2 μm can for example be completely developed after 30 s. The development process can be slowed down for AR 600-50, -55 and -56 by adding 10-20 % of the stopper AR 600-60.
Weaker developers like AR 600-56 and AR 600-546 provide a higher resolution without dark erosion, while a significantly higher sensitivity with at the same time higher dark erosion can be obtained with developers AR 600-55 and AR 600-548. If CSAR 62 is processed with developer AR 600-548 at a development temperature of about 0 °C, even after 10 minutes no erosion is observed at the prolonged development time. Substrates have to be rinsed immediately after development for 30 seconds with stopper and are subsequently dried.
顯影液的選用會影響到顯影速率,敏感度以及阻劑的結構. 基板經阻劑塗佈,曝光後依適合的顯影製程,(puddle,spray, immersion bath). 並將顯影溫度控制21-23℃之間並維持定溫. 顯影時間隨膜厚而變. 膜厚低於0.2um可於30秒後顯影完全. 在AR 600-50, -55, -56顯影劑加入10-20%的AR 600-60(顯影抑制劑)可降低其顯影速度.
較弱的顯影劑,例如 AR 600-56及AR 600-546可提供較高的解析度,而解不會侵蝕膜厚. 相較而言,AR 600-55及AR 600-548可提供較高敏感度,但同時其對膜厚的蝕刻也較高. 低溫顯影亦可降低膜厚侵蝕問提. AR 6200 (CSAR 62) EBL阻劑,以AR 600-548(強顯影劑)在0℃低溫顯影10分鐘也觀察不到膜厚遭侵蝕的問題.
基板需於顯影後30秒內以顯影抑製劑(stopper)沖洗並隨後乾燥.
…