AR 300-475 metal ion free developer
Developer photoresist and Novolac based e-beam resist
…
Product brief 產品簡介
AR 300-40系列為不含金屬離子的鹼性水溶液,適合酚醛系電子束微影阻劑及UV光阻顯影用途。系列產品依濃度不同分為:
AR 300-44 (TMAH 0.26n)
AR 300-46 (TMAH 0.24n)
AR 300-47 (TMAH 0.20n)
AR 300-475 (TMAH 0.17n)
…
Product Packing & Shipping 產品包裝與出貨
Packing 產品包裝:
✅ 2.5 L/瓶
✅ 5 L/瓶
其它包裝可依客戶需求增加.
Shipping 出貨:
✅ 2 – 4 週: 徳國運出
❎ 1 週: 國內庫存
(目前暫無國內庫存)
本產品原廠為德國ALLRESIST GmbH. 瀏覽原廠網頁請按原廠標識。
This product is developed and produced by ALLRESIST GmbH.
Click logo to visit pricipal’s website.

…
Product Features 產品特性
- metal ion-free aqueous-alkaline solutions for the processing of photo/ e-beam resists.
不含金屬離子的鹼性水溶液,做為電子束微影阻劑及光阻的顯影劑. - reduce the risk of metal ion contamination at the substrate surface
減少金屬離子在基板表面造成污染 - residue-free development
顯影後無顯影液殘留 - metal ion content < 0.1 ppm
金屬離子含量<0.1ppm - main component TMAH
主要成分為氫氧化四甲銨(TMAH)
…
Product Properties 產品物性
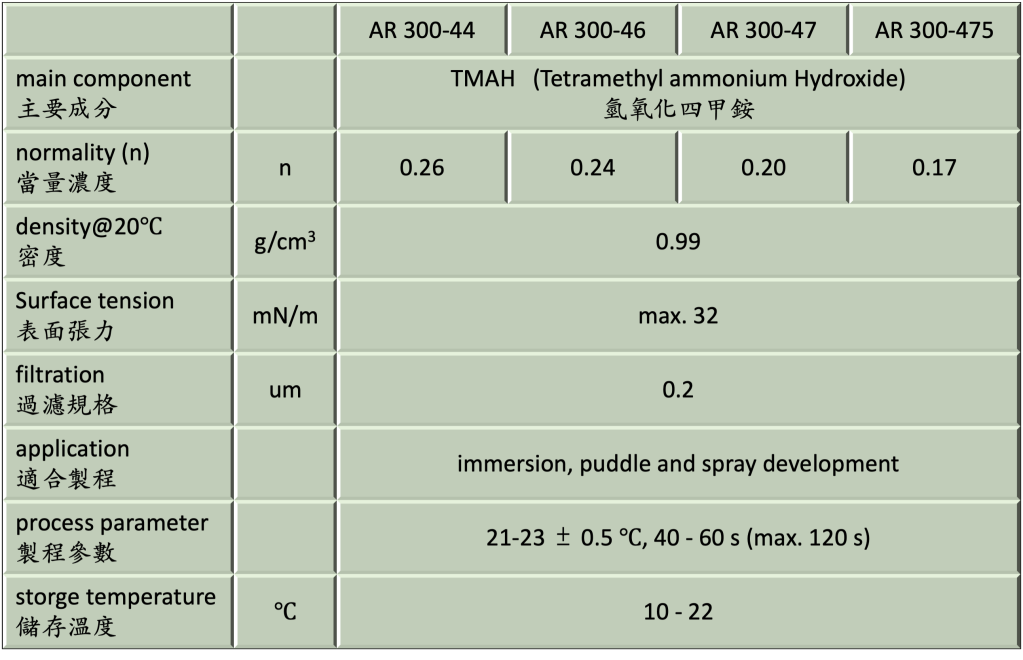
…
Resist and development 適用阻劑
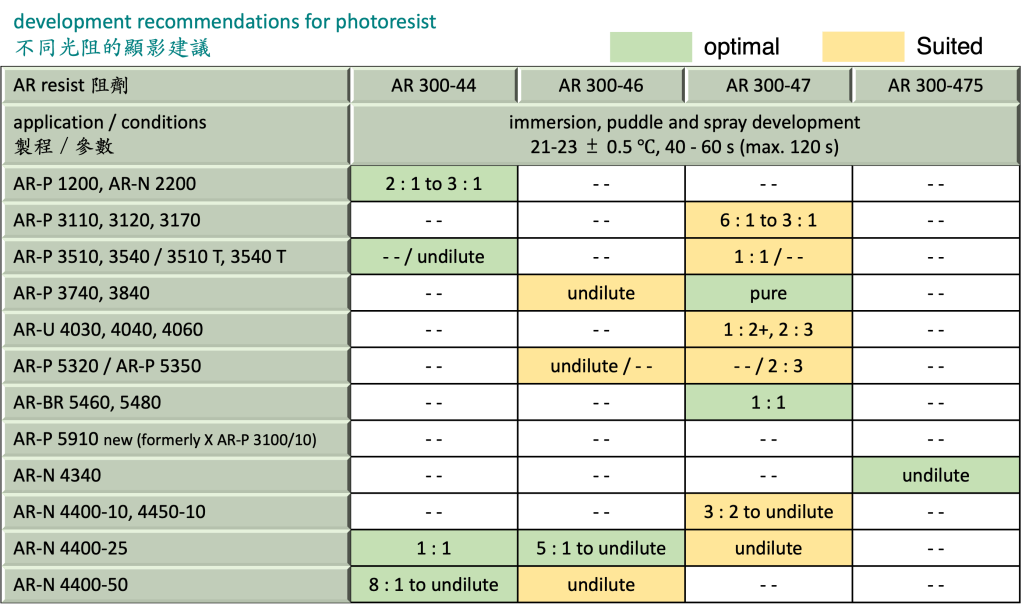

…
Developer processing (→ see also information on developers AR 300-26 and 300-35)
If metal ion-free developers are diluted, it is recommended to adjust the desired normality immediately prior to use by very careful dilution (with scales) of the stronger developer with DI water. Even small differences in normality may cause larger differences in the development rate. Developers should be used as fast as possible, since otherwise developer efficacy may be reduced.
建議稀釋MIF顯影液時:
使用前進行稀釋, 並儘速使用. 未即時使用,可能影響顯影效果.
以較高濃度當量顯影液,用DI water稀釋.
濃度當量計算必須精確, 些微差距可能造成不同的顯影效率
Contents are base on ALLRESIST product TDS.
Click link to ALLRESIST AR 300-475 product page .
內容取材自原廠技術資料,連結原廠請按下方標識。

