Negative e-Beam Resist AR-N 7520-new series
High Resolution EBL Resist for Mix & Match in Semiconductor Process
…
Product brief 產品簡介
AR-N 7520-new系列, 為負型電子束微影阻劑 (negative tone EBL resist). 可以電子束及紫外光曝光(deep UV, I line), 適合於半導體混搭製程(mix & match). 產品系列目前有:
AR-N 7520.07 new
AR-N 7520.11 new
AR-N 7520.17 new
…
Product series & Code 產品比較及編碼說明:

…
Packing 產品包裝:
✅ 100 ml /瓶
✅ 250 ml/瓶
✅ 1 L /瓶
其它包裝可依客戶需求增加.
Shipping 出貨:
✅ 2 – 4 週. 徳國運出
❎ 1 週. 國內出貨
(本品項暫時無國內庫存)
…
Product Features 產品特性
- e-beam, deep UV, i-line (formerly SX AR-N 7520/4)
曝光源可為電子束, 深紫外線, 紫外線(i-line). (開發時期型號為SX AR-N 7520/4) - short writing times, very high contrast
轉寫時間短, 對比度高 - mix & match processes between e-beam and UV exposure 248-365 nm, negative in the UV range
適合電子束與紫外線 (248 – 365 nm)的混搭製程, 紫外線曝光下為負型模式 - highest resolution, very process-stable (no CAR)
非化學放大型,但解析度高,製程穩定
- plasma etching resistant, temperature stable up to 140 °C
耐乾蝕刻, 高溫穩性定達140℃ - novolac, organic cross-linking agent
主要成份含酚醛樹酯, 有機物架橋劑等 - safer solvent PGMEA
溶劑使用較安全的丙二醇甲醚醋酸酯
…
Product Properties 產品物性
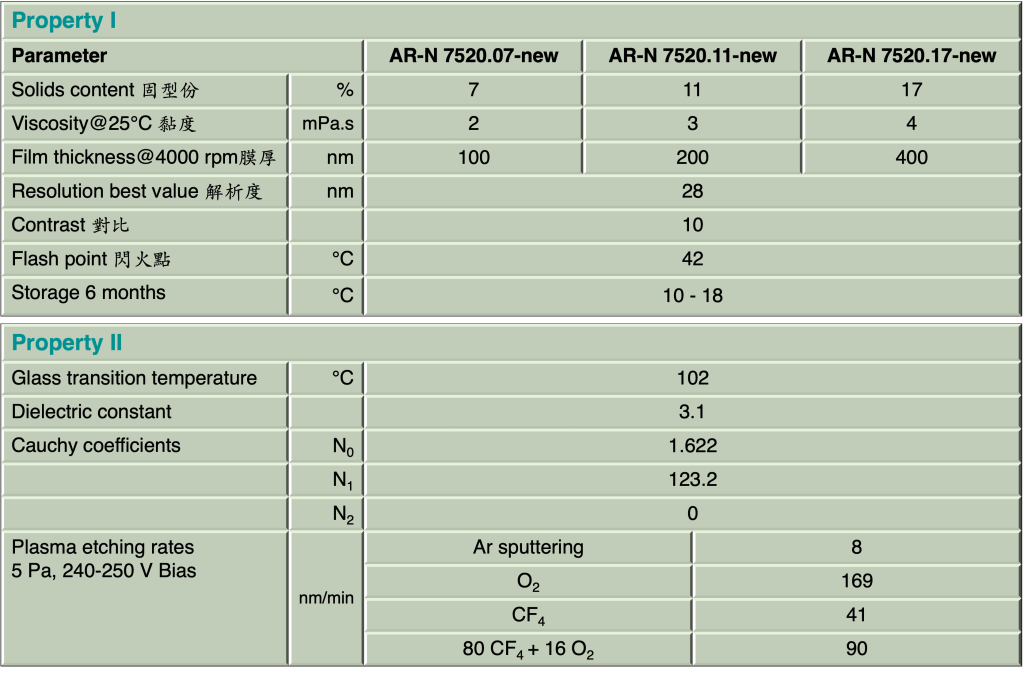
…
Spin curve 塗佈曲線
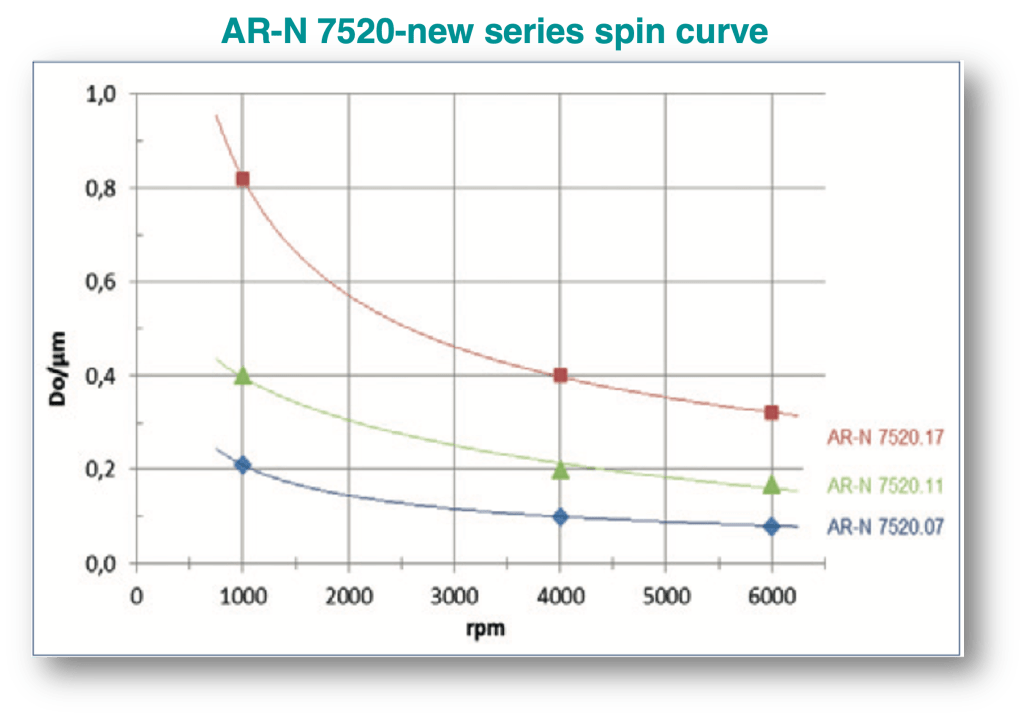
…
Structure resolution
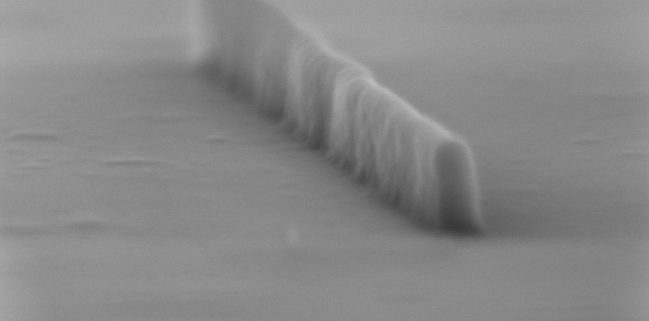
AR-N 7520.07 new: 30-nm lines at a film thickness of 90 nm
Resist structures
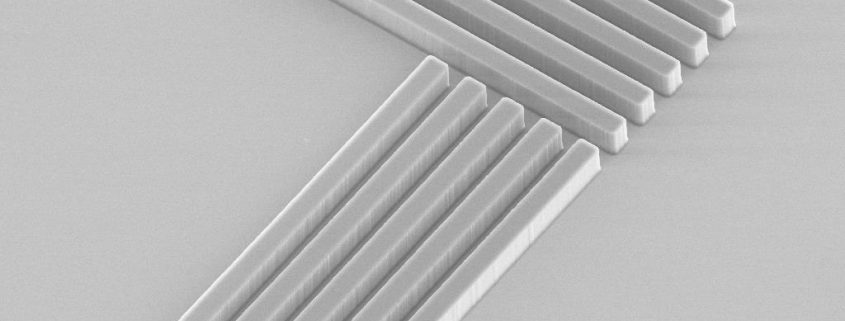
AR-N 7520.17 new: 400- and 600-nm lines, film thickness 400 nm
Process parameters
| Substrate | 4″ Si wafer |
| Soft bake | 85℃x90sec, hot plate |
| Exposure | Raith Pioneer, 30kV |
| Development | AR 300-47, 60sec 22℃ |
…
Process baseline 製程參數
This diagram shows exemplary process steps for resists of AR-N 7520-new series. All specifications are guideline values which must be adapted to own specific conditions. For further information on processing, 👉 “Detailed instructions for optimum processing of e-beam resists”. For recommendations on wastewater treatment and general safety instructions, 👉”General product information on Allresist e-beam resists”.
表列為AR-N 7520 new阻劑產品製程參數的範例. 所有參數為參考值,使用者應依設備環境實際狀況加以調整
| Process | AR-N 7520.17 new | AR-N 7520.07 new |
|---|---|---|
Coating | 400nm@4000 rpm x 60sec | 100nm@4000 rpm x 60 sec |
soft-bake (±1℃) | 85℃ x 1 min/hot plate, or 85℃ x 30 min/convection oven | 85℃ x 1 min/hot plate, or 85℃ x 30 min/convection oven |
| e-Beam exposure dose (E0) 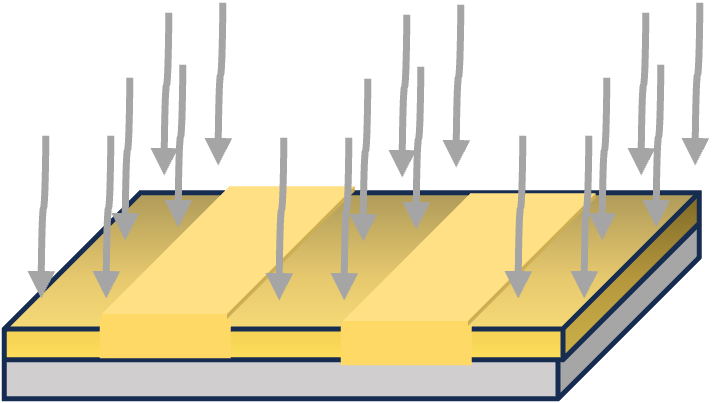 | Raith Pioneer, 30kV 30 uC/cm2 ,100 nm line & space | Raith Pioneer, 30kV 30 uC/cm2 ,100 nm line & space |
| Development 21-23℃ puddle 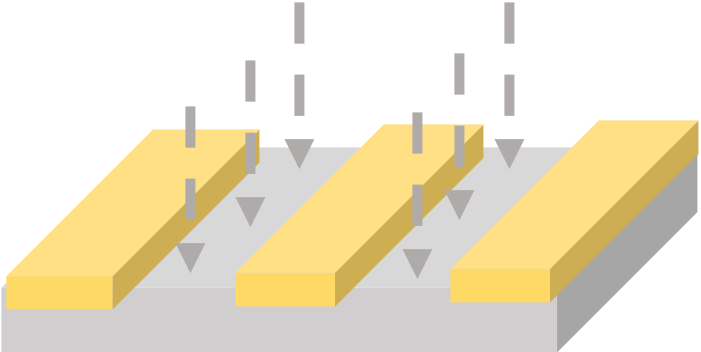 | AR 300-46, 90 sec | AR 300-47, 50 sec |
Rinse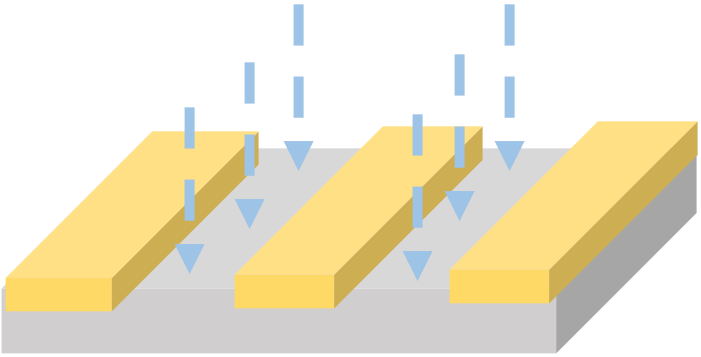 | DI water, 30 sec | DI water, 30 sec |
| Post-bake (optional) 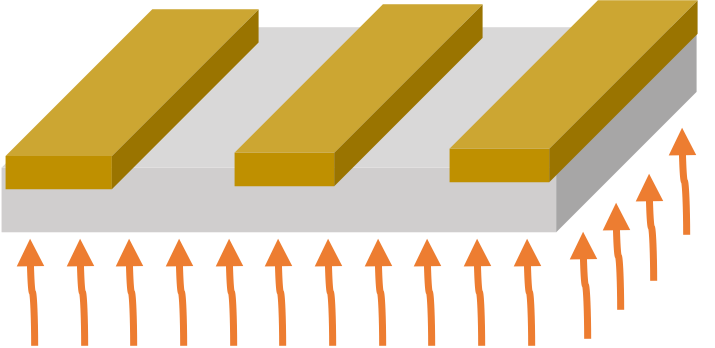 | 85 ℃ x 1 min hot plate, or 85 ℃ x 25 min convection oven for enhanced plasma etching resistance | 85 ℃ x 1 min hot plate, or 85 ℃ x 25 min convection oven for enhanced plasma etching resistance |
| Customer specific process 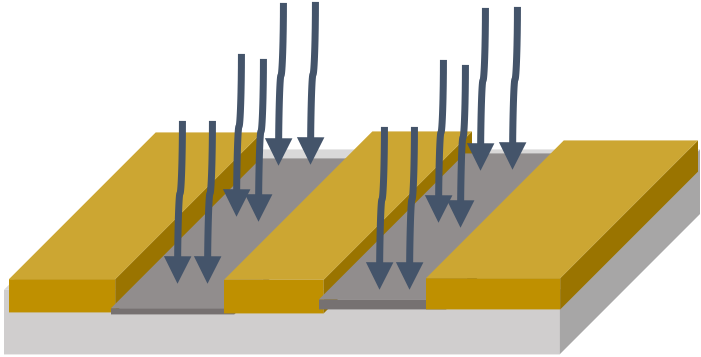 | Generation of semiconductor properties | Generation of semiconductor properties |
Removal | AR 300-73, or O2 plasma ashing | AR 300-73, or O2 plasma ashing |
…
Development recommendation
…
Process instruction 製程說明
These resists are predestined for e-beam exposure, but also suitable for UV exposure. Mix & match processes are possible, if both exposure methods are carefully coordinated. During e-beam exposure, the resist works in a negative mode.
The resist works also in a negative mode with deep UV (248-270 nm) or mid-UV (290-365) exposure. If a further tempering step (85 °C, 2 min hot plate) is added after image-wise exposure, the sensitivity can be slightly enhanced.
The developer dilution should be adjusted with DI water such that the development time is in a range between 20 s and 120 s. By dilution of the developer, contrast and development rate can be influenced to a large degree. A stronger dilution results in an increased contrast and a reduced development rate.
AR-N 7520-new系列是設計為電子束微影阻劑,但也適合於紫外線曝光. 兩種曝光參數經適當調配,可用於半導體混搭製程(mix & match).阻劑在電子束曝光下為負型模式.
在深紫外線(248-270 nm)及中紫外線(290-365 nm)下曝光亦為負型模式. 曝後烤(85℃ x 2 min, 熱板)可些微增加敏感度.
顯影劑濃度視需要以純水調整,建議的顯影時間為 20 – 120 sec.
稀釋顯影劑對對比度及顯影率影響很大. 過度稀釋會降低對比度及顯影速率.
…