Negative poly(hydroxystyrene) and (hydroxystyrene-co-MMA) photoresist with high-temperature stability
As an alternative to the polyimide negative resist, SX AR-N 4340/6 was developed, a highly sensitive CAR negative resist based on polyhydroxystyrene, which can be developed under aqueous-alkaline conditions. The resist layers are very well suited for the fabrication of high-temperature resistant structures, which are stable up to approximately 350°C (see figure 1).
耐高溫光阻有了更多選擇,相較於聚醯亞胺(polyimide), SX AR-N 4340/6為聚羥基苯乙烯基為基礎,以鹼性水溶液為顯影劑的化學增幅型負光阻. 適合形成耐高溫結構. 下圖為升溫至350℃的阻劑結構,仍能維持表面及側壁平順.
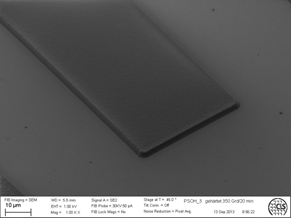
Figure 1: SEM micrograph of a structure of SX AR-N 4340/6 with smooth surface and sharp edges, tempered at 350 °C .
There is merely a shrinkage of up to 20 % (see figure 2).
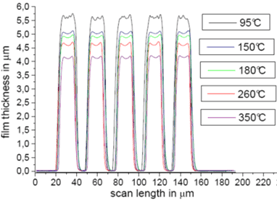
Figure 2: Shrinkage depending on temperature, measurement on Dektak 150.
The structures of the new thermostable positive resist SX AR-P 3500/8 likewise show a high resistance to high temperatures that may occur during intensive etching or implantation processes. Most commercial removers solve the resist layers easily after thermal stress up to 130 °C. In case of higher temperatures, the aqueous-alkaline remover AR 300-73 must be used. The tempered structures (above 150 °C) are inert to solvents, which allows for application in microfluidics. SX AR-N 4340/6 is suitable for other technologies as well, seeing that the resist shows high plasma etching stability and good insulating qualities besides its temperature stability.
另一款耐高溫的光阻為正型的SX AR-P 3500/8, 在高強度蝕刻或植入的製程中表現良好的熱穩定性.
光阻在低於130℃的溫度製程後,一般市售的光阻去除劑都能去除. 如果製程溫度高於130℃則必需使用含鹼的溶液,例如AR 300-73 去除劑*1
溫度高於150℃則不易去除,可使用於微流道結構的應用.
除耐高溫外,SX AR-N 4340/6 在電漿蝕刻的高穩定度及其絕緣特性,也適合其它應用技術.
As an alternative to the polyhydroxystyrene negative resist, a sensitive CAR negative resist based on the copolymer poly(hydroxystyrene- co -MMA) was designed which can also be developed under aqueous-alkaline conditions. The resist SX AR-N 4340/7 is stable up to temperatures of at least 250°C and thus also well suited for the generation of high-temperature stable structures. Similar to polyhydroxystyrenes, this resist is characterised by good insulating properties and a high thermal resistance. Resist layers of PSOH co MMA show only very low moisture absorption from the air.
除了聚羥基苯乙烯, SX AR-N 4340/7 以羥基苯乙烯與甲基丙烯酸甲酯共聚物為基礎的增幅負型光阻,輔以鹼性溶液為顯影劑; 可耐高溫達250℃. 適合高溫應用.
除耐高溫與絕緣特性與聚羥基苯乙烯類似, 此共聚物光阻層具有低吸水率.
Overview of negative photoresist
Alkali-stable and solvent-stable negative resist
Chemically enhanced negative resist (Process parameters and resolution)
Chemically enhanced negative resist without cross-linking
Coloured negative photoresists
Development of thick negative resist layer
Dose-dependent structure size with negative resists
Fabrication of vertical flanks with CAR 44
Generation of undercut structures with negative resists
Negative polyimide photoresist
Negative two- layer lift-off system
NIR-laser structurable photoresists
poly(hydroxystyrene) and (hydroxystyrene-co-MMA) photoresist with high-temperature stability
Sensitive negative PMMA resist (CAR)
Sensitive negative resist for 405 nm laser direct exposure